Intel представила стеклянную подложку для сложных чипов будущего с EMIB
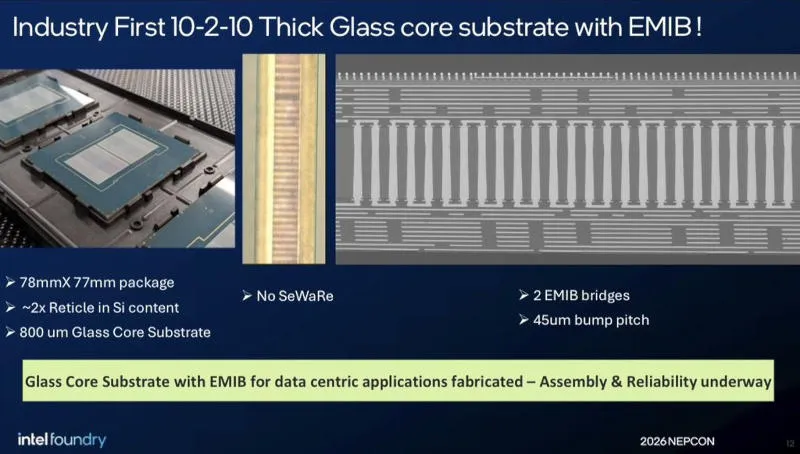
Intel представила на выставке NEPCON Japan 2026 новую технологию стеклянных подложек, которая поможет в производстве чипов для ускорителей искусственного интеллекта и сферы высокопроизводительных вычислений.
Подложки размером 78 × 77 мм достаточно для всего корпуса чипа — она способна разместить примерно вдвое больший размер фотошаблона по сравнению с кремнием — около 1716 мм² для логики и памяти. Это первая стеклянная подложка в конфигурации 10-2-10 с поддержкой технологии многочиповых модулей Intel EMIB. На верхней части размещаются десять RDL-слоёв интерпозера для перераспределения сигналов от кристалла.
Основу подложки составляют два слоя, и изготавливается она из материала класса 800 мкм (0,8 мм), который может включать внутренние металлические слои для схем со сквозными отверстиями в стекле (TGV), пластин питания или заземления. Последнее число «10» обозначает количество слоёв на нижней стороне — зеркальное отражение верхних для подключения к плате. Этот слой также служит для того, чтобы упорядочить множество проводов на кристалле.
Ещё одно достоинство подложки Intel 10-2-10 — шаг контактной площадки составляет всего 45 мкм. Наконец, встроены два моста EMIB для многочиповой модульной упаковки — то есть можно устанавливать на подложку несколько чипов небольшого размера и соединять их по EMIB. Intel также нашла некое решение, позволяющее избежать проблемы SeWaRe — растрескивания стекла при производстве.
Стеклянные подложки отличаются повышенной сложностью в производстве по сравнению с органическими, поэтому разработкой данной технологии занимается относительно небольшое число компаний. Среди сильных сторон, однако, перечисляются термостойкость, предотвращение деформации и улучшенная электрическая изоляция — задержки сигнала и помехи в плотно связанных областях снижаются, а плотность межсоединений возрастает.
